据瑞银集团(UBS)研报,英特尔代工(Intel Foundry)近期在行业内受到高度关注,多家全球头部科技公司有望在今年秋季宣布新的代工合作承诺,英特尔被认为正处于拿下多份重要新合同的“临门一脚”。 瑞银指出,英特尔近期发布的 14A 工艺节点 1.0 版工艺设计套件(PDK)是推动这些潜在订单进入决策阶段的关键催化剂。
过去一段时间,市场上不断传出消息称,苹果、AMD、英伟达、Google以及博通正考虑采用英特尔的晶圆制造能力,其中包括 18A、18A-P、18A-PT 等先进工艺节点,以及后续的 14A 节点。 传闻显示,苹果有望在 2027 年将部分 M 系列“Apple Silicon”笔记本处理器转移至英特尔 18A-P 节点生产;Google则可能在部分 TPU(张量处理器)产品中,利用英特尔的 EMIB 与 Foveros 3D 等先进封装技术。
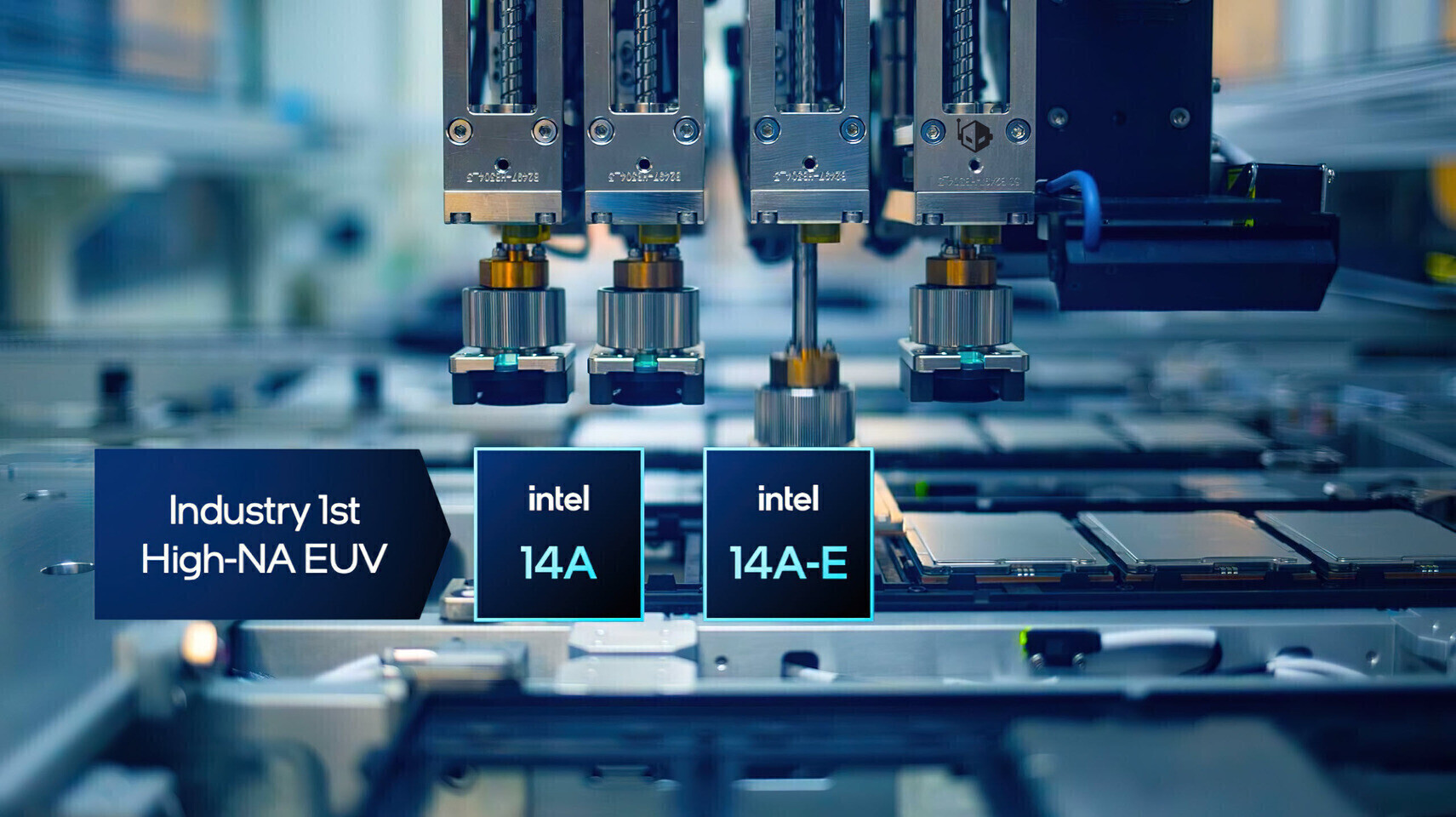
目前,各大芯片设计公司在评估领先制程时,通常仍优先选择台积电,原因在于其成熟的良率与大规模产能,以及在高性能、低功耗设计方面经过充分验证的先进封装能力。 不过,英特尔近年持续加大在代工业务上的资本与供应链投入,积极争取外部客户,这也是瑞银预期今年秋季将集中出现多笔代工承诺公告的背景。 去年年底曾有消息称,苹果在观望英特尔 18A-P PDK 1.0 与 1.1 版本的发布进度,计划分别在 2026 年第一、二季度释出,如今已进入第二季度,外界正等待更多迹象确认苹果是否最终敲定合作,而瑞银方面倾向认为苹果已经选择继续推进。
除晶圆制造本身外,英特尔在先进封装领域同样被视为重要突破口。 通过 EMIB、以及其扩展版本 EMIB-T 和 EMIB-M,客户可以基于 2D、2.5D 与 3D 形态,将多个芯粒(chiplet)与多颗 HBM 高带宽存储整合到单一封装之内。 英特尔曾展示过在单一封装中整合多达 47 颗小芯片的方案,并提出面向多千瓦级功耗封装解决方案的长期构想。 相比之下,台积电目前的主力先进封装技术 CoWoS 据称在处理四块光罩尺寸的大芯片时面临一定挑战,这也已经给英伟达部分高端产品的量产带来了压力和潜在产能瓶颈。
在美国及其盟友希望重塑本土半导体供应链的大环境下,英特尔代工若能同时在先进制程与先进封装两条线上取得更多大客户订单,将显著巩固其在全球晶圆代工格局中的地位,并为高端计算、AI 加速与高带宽封装等领域带来更多供应来源选择。